在近日举行的英特尔电子元件技术大会(ECTC)上,一系列创新的芯片封装技术被隆重推出,这些技术不仅揭示了未来半导体封装领域的发展方向,还展示了如何通过优化封装技术来大幅提升芯片的性能和效率。
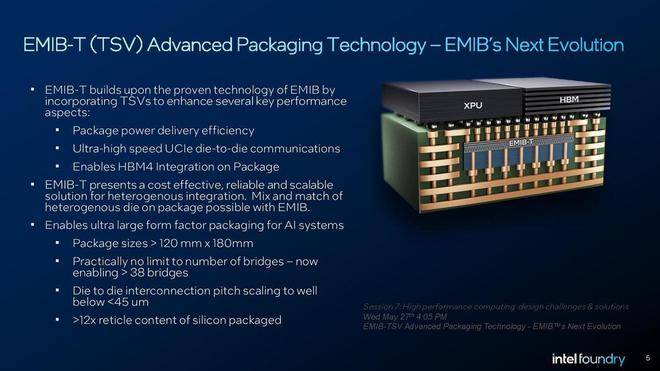
在众多引人注目的封装技术中,EMIB-T技术尤为突出。这一技术专为提升封装尺寸和供电能力而设计,以更好地支持如HBM4/4E等前沿技术。通过采用硅通孔(TSV)技术,EMIB-T实现了从封装底部直接、低电阻的供电路径,解决了传统EMIB连接中高电压降的问题。同时,TSV还显著提升了芯片间的通信带宽,使用UCIe-A互连技术,数据传输速率可达32 Gb/s甚至更高。
EMIB-T技术的另一个显著优势在于其支持更大的封装尺寸,最大可达120 x 180 mm,能够在一个大型封装中集成超过38个桥接器和12个以上的裸片。EMIB-T还支持35微米的凸块间距,且25微米间距的研发也在进行中,这相较于初代和第二代EMIB技术有了显著的提升。
除了EMIB-T技术外,英特尔还展示了一种全新的分散式散热器设计。这种设计将散热器分解为平板和加强筋,从而改善了散热器与热界面材料(TIM)之间的耦合效果,并有助于减少TIM耦合焊料中的空隙达25%。英特尔还推出了一款集成微通道的散热器,该散热器能够直接通过IHS冷却处理器,支持高达1000W TDP的处理器封装。

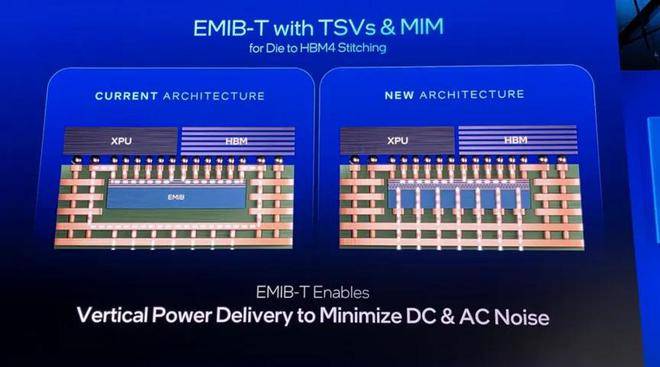
在封装技术的另一个重要领域,英特尔还开发了一种新型的热压粘合工艺。这一工艺特别适用于大型封装基板,能够有效克服芯片和基板在粘合过程中的翘曲问题。通过最大限度地减少键合过程中封装基板和芯片之间的热差,这一工艺显著提高了良率和可靠性指标,并实现了比当前大批量生产更大的芯片封装。
这一新型热压粘合工艺还能够实现更精细的EMIB连接间距,从而进一步提升了EMIB-T技术的密度和性能。这一技术的突破对于未来高性能计算和低功耗应用的发展具有重要意义。
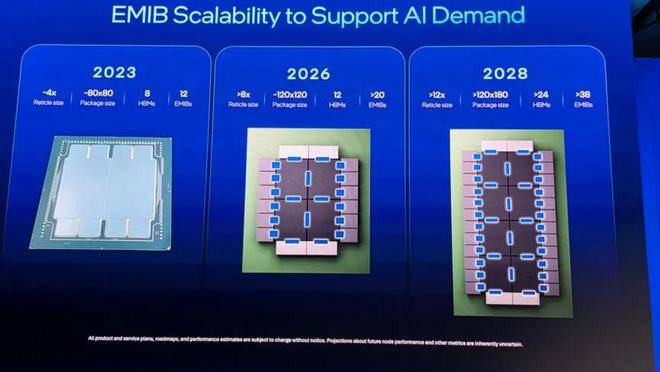
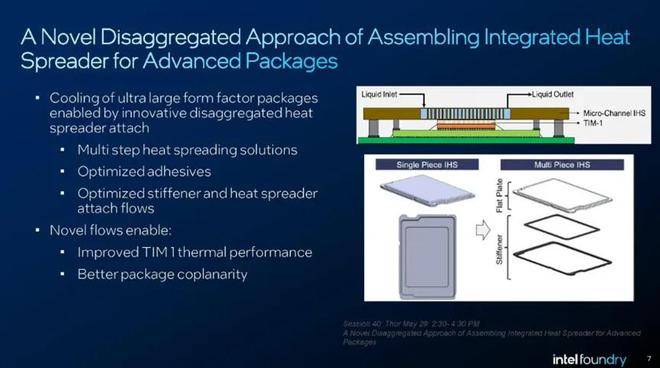
英特尔代工厂作为这些先进封装技术的实践者,正致力于利用尖端工艺节点技术为内部和外部公司生产芯片。随着处理器设计日益复杂,异构计算成为主流,英特尔通过先进的封装技术将多种计算和内存组件集成到单个封装中,不仅提升了性能,还优化了成本和能效。







